- HOME >
- 専門家による技術解説 >
- フォトレジスト材料と要求特性
フォトレジスト材料と要求特性
2024.01.31
フォトレジスト材料と要求特性
フォトレジストは半導体の高集積化を支えるリソグラフィ技術の主幹をなす材料である。
解像性向上のために短波長化される光源の波長に合わせて開発が進められてきた。現在では最小パターン線幅12nmのフォトレジストパターンの形成が行われている。
本稿では、フォトレジストの基礎とその要求特性についてまとめる。
1. 露光波長とレジスト材料
表1は、露光光とそれに用いられるレジスト材料の関係を示している。
表1. 露光光とレジスト材料の関係
| 露光光 | 紫外線(g,i線) | 遠紫外線(KrF,ArFエキシマレーザ) 極端紫外線(EUV) |
| レジストの反応形態 | 溶解阻害 | 化学増幅 |
| ポリマー | ノボラック樹脂 | KrF:ポリヒドロキシスチレン系 ArF:ポリアクリル酸系 EUV:ポリヒドロキシスチレン系,ポリアクリル酸系 |
| 感光体 | ジアゾナフトキノン (溶解阻害剤) | 光酸発生剤 |
紫外線のg線(436nm),i線(365nm)露光では、溶解阻害型レジスト,遠紫外線のKrFエキシマレーザ(248nm),ArFエキシマレーザ(193nm)露光,極端紫外線のEUV(13.5nm)露光では、化学増幅型レジストが使用される。なおEUV露光では非化学増幅型ネガレジストが使用されることもある。溶解阻害型レジストは、ポリマーにノボラック樹脂,感光体に溶解阻害剤のジアゾナフトキノン,化学増幅型レジストは、感光体に光酸発生剤が用いられる。化学増幅型レジストのポリマーとしては、遠紫外線露光では露光光に対して透明なものが求められることから、KrFエキシマレーザ露光にはポリヒドロキシスチレン系,ArFエキシマレーザ露光にはポリアクリル酸系が使用される。EUV露光では透明性の課題がないために、ポリヒドロキシスチレン系,ポリアクリル酸系のいずれも使用できる。
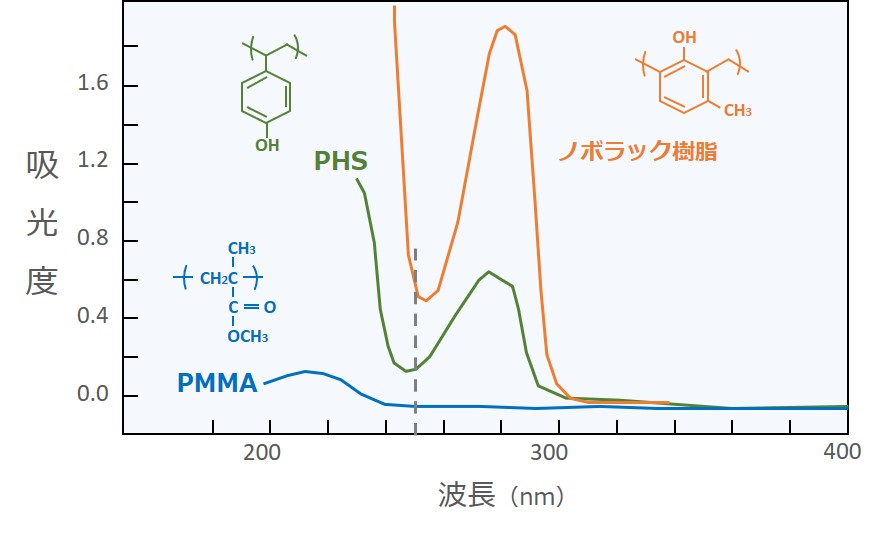
図1. ポリマーの吸光度
図1は、ポリマーの吸光度について示している。ノボラック樹脂は300nm以上で吸光度が低く(透明性が高く)、g線,i線露光に適していることがわかる。ポリヒドロキシスチレン(PHS)はKrFエキシマレーザの248nm付近に透明性が高くなっていて、この波長の露光に使用できる。ポリメチルメタクリレート(PMMA)は短波長領域まで透明性が高く、193nmのArFエキシマレーザ露光に用いることがでる。ただし、ポリメチルメタクリレートはベンゼン環を含まないためにドライエッチング耐性は不良となる。
2. 溶解阻害型レジスト
図2は、溶解阻害型ポジ型レジストの組成(上図)と溶解阻害剤であるジアゾナフトキノンの光化学反応(下図)を表している。溶解阻害型ポジ型レジストは、ノボラック樹脂(上図左)とジアゾナフトキノンスルフォン酸エステル(上図右)を例えばベンゾフェノン骨格に置換したもの(上図中央)の混合物を溶剤に溶解させたものである。ジアゾナフトキノンスルフォン酸エステルを配位する骨格の種類と置換数によって、レジストの感度、溶解阻止効果等が決定される。ジアゾナフトキノンは露光によりジアゾ基が消失し(下図左から2番目)、ケテン化合物に転移反応し(下図右から2番目)、空気中の水分と反応してインデンカルボン酸となる(下図右)。

図2. 溶解阻害型ポジ型フォトレジストの組成とジアゾナフトキノンの光化学反応
図3は、溶解阻害型ポジ型レジストのパターン形成原理について示している。ノボラック樹脂,ジアゾナフトキノンスルフォン酸エステルとノボラック樹脂の混合物,インデンカルボン酸とノボラック樹脂の混合物のそれぞれのアルカリ水溶液に対する溶解性を表している。ノボラック樹脂のアルカリ溶解性は、ジアゾナフトキノンスルフォン酸エステルと混合することにより消失し、アルカリ不溶となる。一方、露光して生成したインデンカルボン酸とノボラック樹脂の混合物は、ノボラック樹脂以上のアルカリ溶解性を示している。ジアゾナフトキノンスルフォン酸エステルの溶解阻害効果がなくなり、アルカリ可溶のカルボン酸に変成したためである。このように、露光部(右端)と未露光部(中央)のアルカリ溶液に対する溶解性の差が大きくなることから、未露光部のレジストが残存するポジ型パターンが得られることになる。
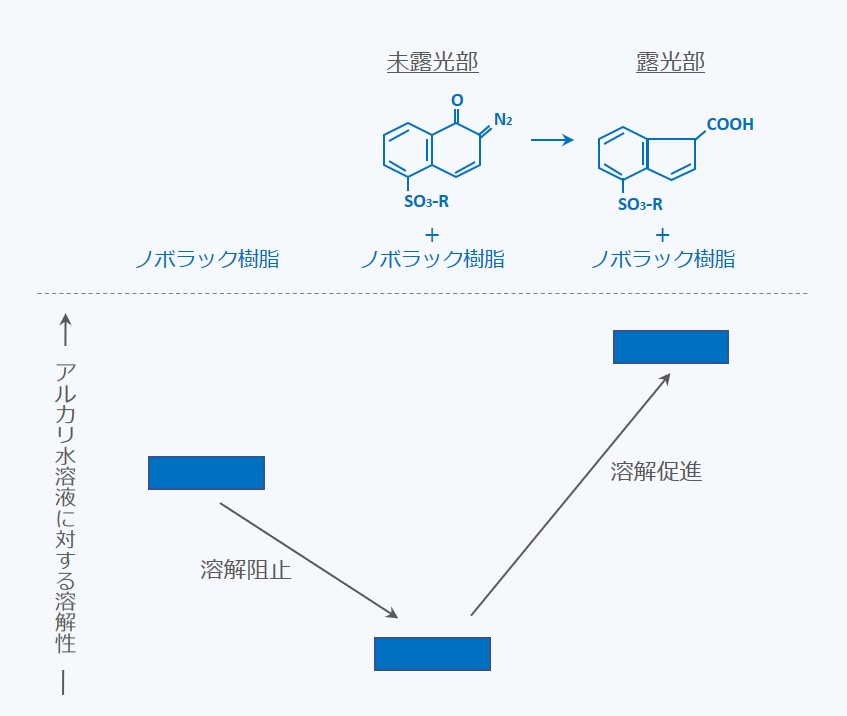
図3. 溶解阻害型ポジ型レジストのパターン形成原理
3. 化学増幅型レジスト
図4は、化学増幅型レジストの反応について示している。KrFエキシマレーザ露光に用いられるポリヒドロキシスチレン系のポリマー(ポリ(t-ブチルオキシカルボニルオキシスチレンーヒドロキシスチレン))を例にしている。このポリマーは、アルカリ現像液に不溶であるが、レジスト中の光酸発生剤は光を照射すると酸を発生し、加熱下でのこの酸の働きによりt-ブチルオキシカルボニル(t-BOC)基が脱離して、アルカリ現像液に可溶なポリマー(ポリヒドロキシスチレン)に変わり、同時に酸を発生させる。この酸は、再びアルカリ現像液に不溶なポリマーに働き、同じ反応を繰り返す。化学増幅型と呼ばれる理由である。
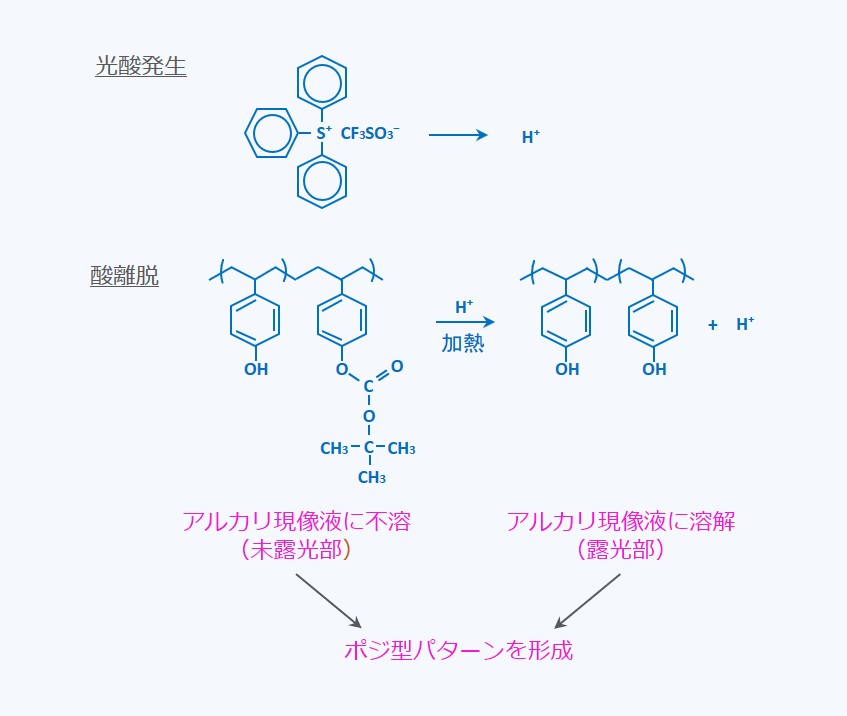
図4. 化学増幅型レジストの反応
化学増幅型レジストは、未露光部がアルカリ現像液に対して不溶、露光部がアルカリ現像液に対して可溶という極性の変化が大きいために、溶解阻害型レジストに比べて解像性がより向上することが特徴である。なお、露光前のポリ(t-ブトキシカルボニルオキシスチレン)、露光後のポリヒドロキシスチレンともに、KrFエキシマレーザ光に対する透明性は良好で解像性の良好さを支えている。また、少ない露光量で酸を触媒として反応を連鎖的に起こすことから、感度が著しく向上する。

図5. ArF化学増幅型レジストのポリマー
図5は、ArF化学増幅型レジストのポリマーについて示している。ArF化学増幅型レジストでは193nmに低吸収のポリマーの選択が重要であり、アクリルポリマーでまず開発された。アクリルポリマーはドライエッチング耐性が不良であることから、ArFエキシマレーザ光に対して透明性を維持したままドライエッチング耐性を向上させるためにアクリルポリマーにアダマンチル基の脂環基を含有させることが開発された。またアダマンチル基を酸脱離基としても用いるために、2-メチル-2-アダマンチル基が開発された。アダマンチル基はArF化学増幅型レジストに必須のドライエッチング耐性向上基として使用されている。
ArF化学増幅型レジストのうち、ウエハーと縮小投影レンズ間を水で満たして露光を行うArF液浸リソグラフィ用のレジストとしては水の浸入、水へのレジスト成分溶出を抑制するようなレジストの設計が求められる。フッ素含有ポリマーをレジストに添加して、レジスト膜表面に疎水性の大きいフッ素を局在化させることにより、液浸露光による水の影響を遮り、現像時の障害も少ないというArF液浸化学増幅型レジストが提案されている。

図6. 化学増幅型レジストのポリマーのまとめ
図6に化学増幅型レジストのポリマーのまとめを示す。KrF化学増幅型レジストのポリマーは、ポリヒドロキシスチレンを酸脱離基で一部保護化したものを用いる。ArF化学増幅型レジストのポリマーは、アダマンチル基の脂環基のエッチング耐性向上基,酸脱離基,基板との密着性基としてのラクトン基を含有したアクリルポリマーを用いる。
最先端のEUV光を用いたリソグラフィが実用化され、フォトレジストの果たす役割は益々重要となっている。今後の一層の発展が望まれている。
株式会社英知継承では、本テーマに関して当該専門家による技術コンサルティング(技術支援・技術協力)が可能です。下記よりお気軽にお問い合わせください。
▼「半導体技術」に関連する技術解説一覧







