- HOME >
- 専門家による技術解説 >
- EUVリソグラフィの要素技術と今後の動向
EUVリソグラフィの要素技術と今後の動向
2024.07.17
EUVリソグラフィの要素技術と今後の動向
1. EUVリソグラフィの特徴
メモリー、マイクロプロセッサ等の半導体の高集積化の要求は、携帯端末、情報機器等の高性能化に伴い益々大きくなっている。リソグラフィによる微細加工技術は、半導体の高集積化の要であり、常に革新されてきた。この中でEUVリソグラフィは、スマートフォン用のデバイス等の最先端デバイス(3nmロジックノード(最小パターン線幅12nm))の製造に用いられている。
EUVリソグラフィは、光源から放射される波長の短い極端紫外線(Extreme Ultra Violet(EUV):13.5nm)を用いて、真空下で縮小転写するリソグラフィである。従来から用いられている遠紫外線(248nm(KrFエキシマレーザ光),193nm(ArFエキシマレーザ光))等に比べて圧倒的に短い波長を用いるために、解像性が著しく向上する。
本稿ではEUVリソグラフィの要素技術を紹介し、今後の動向についてまとめる。
2. EUV光源
光源はレーザープロデューストプラズマ(LPP)という方式が用いられる(図1)。CO2レーザをSnの液滴に照射し、そこから発生するプラズマ光のうち13.5nmの波長の光を集光する方式である。CO2レーザのエネルギーからEUV光への変換効率が5%以下程度なので、光量が上がらないことがEUVリソグラフィ全体の最大課題であったが、現在では中間集光点で250W以上の出力が確認され、露光装置のスループット160ウエハー/時間を達成している。ただし最新のArF液浸エキシマレーザ露光装置のスループット(250ウエハー/時間)に比較すると未だ劣るので、EUV光源はより出力の増加が求められている。
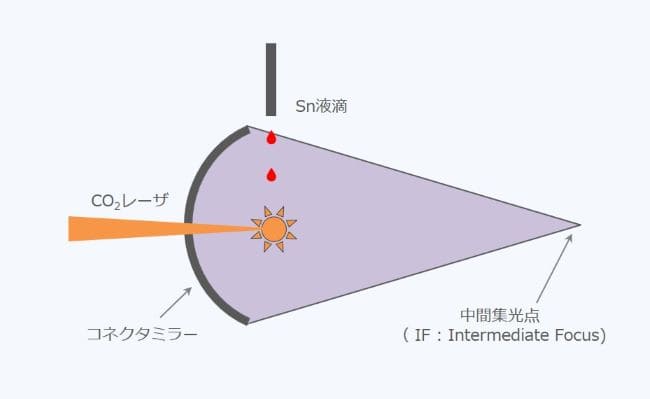
図1. レーザープロデューストプラズマ(LPP)によるEUV光源
3. 光学系・マスク
13.5nm のEUV光はほとんどの物質に吸収されるために、真空中露光で、反射光学(照明、投影)系(反射ミラー)、反射型マスクを用いる。光学系としては従来の屈折レンズに代わる大きな変革となる。
反射型マスクは、Si/Moの多層膜(反射膜)上にTaN、Cr等のEUV光の吸収体という構造である。SiとMoは約6.5nmピッチ(一周期)で40層以上の多層膜とすることにより、70%弱のEUV光の反射を行う。ここで多層膜上のパターン欠陥は修正できるが、多層膜中にパーティクルが入ったことによる多層膜欠陥は修正できないため無欠陥マスクが必要となる。
なお、照明光は6度でマスクに入射し、マスクの吸収体は高さがあるため、パターンの方向により影が発生するとういう課題が生じるので吸収体のサイズは影を考慮して作成する必要がある。
4. プロセス
EUVリソグラフィのパターン転写構造は図2に示すような多層構造となる。アンダーレイヤーは、レジスト塗布均一性向上、パターン形状制御、パターンラフネス低減、パターン倒れ防止、感度向上等の働きを行う。スピン・オン・グラス(SOG)はSi系の材料で、ハードマスクとしてレジストだけでは不足する加工基板のエッチング耐性向上を担う。スピン・オン・カーボン(SOC)はカーボン系の材料で、焦点深度の小さい超薄膜(約30nm以下)のEUVレジスト膜の平坦化を行う。アンダーレイヤーの機能を保持したメタル系のハードマスクも提案されており、この場合、アンダーレイヤーは不要となる。
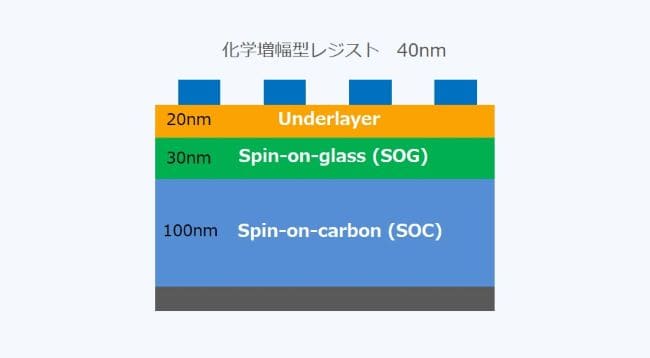
図2. EUVリソグラフィのパターン転写構造
5. レジスト
EUVレジストでは、感度、解像度、ラフネスのトレードオフという課題がある。(ハーフピッチ)3X(ラインエッジラフネス)2X感度で定義されるZファクターの値が小さいほどバランスのとれたトレードオフの課題が少なく性能のよいEUVレジストとされている。
感度については、化学増幅型EUVレジストの酸発生機構が従来の化学増幅型レジストと異なるため設計指針も異なる。EUVレジストでは、レジスト中のポリマーがEUV光を受けとってイオン化し、2次電子を放出する。2次電子がレジスト中の酸発生剤に吸収されて酸を発生することになる。このようにポリマーのイオン化、酸発生剤の電子受容性が感度向上につながることになる。このためEUV光に吸収が大きいフッ素元素等のレジストへの導入が検討されている。
解像度、ラインエッジラフネスについては、発生した酸が過度に動くと性能の劣化につながるため、酸拡散長が短い酸発生剤が求められる。酸発生剤がポリマーにバウンドしたようなポリマーバウンド酸発生剤等が提案されている。
また、EUVでは1個あたりのフォトンのエネルギーが高い(193nmに比べて約14倍)ために、レジスト解像に必要なフォトン数が非常に少なく、ばらつきが大きくなる。このためランダム欠陥の発生(Stochastic effects)の課題がある。ばらつきの大きいフォトンから発生する二次電子、化学増幅反応もばらつきが大きくなりラフネスが増大するためである。原理的に露光量を多くすれば欠陥は低減するが感度の低下にもつながるので、光源出力のより向上が求められる。
Snなどのメタルを含有したレジストは、EUV光をより吸収し非化学増幅型でも高感度になるために注目されている。メタルレジストはエッチング耐性が向上するので、プロセスの簡易化という利点もある。メタルレジストを使用することにより、通常の化学増幅型レジストを使用する場合のアンダーレイヤー、ハードマスク(スピン・オン・グラス(SOG))を省いた平坦化層(スピン・オン・カーボン(SOC))のみ使用のプロセス構造が可能となる。また薄膜で用いることができることから、パターンの倒れを防止して解像性の向上にもつながる。
6. 露光装置
現在は縮小投影光学系のNA(Numerical Aperture:開口数)0.33のNXE3600DがASML社から市販され最先端デバイスの製造に使用されている。NAは大きいほど解像性が向上するためにより大きいNAの露光装置が開発されており、2025年に2.1nmロジックノード(最小パターン線幅10nm)対応の高NA(0.55)EUV露光装置が量産工程に導入される予定である。
7. EUVリソグラフィの延長
今まで最前線で用いられてきたArF液浸エキシマレーザリソグラフィは、ダブルパターニング/マルチパターニングという手法でその解像性を大きく向上させて用いられてきた。EUVリソグラフィについてもこれらの手法は同様に用いることができ、先に述べた高NA露光装置とともに次世代デバイスへの主力の対応となる。
8. おわりに
EUVリソグラフィの技術と今後の動向についてまとめた。量産適用がまさに行われており、光源、レジストについて課題の早期解決が必要である。次世代デバイスへの適用時の課題の見いだしも重要である。
株式会社英知継承では、本テーマに関して当該専門家による技術コンサルティング(技術支援・技術協力)が可能です。下記よりお気軽にお問い合わせください。
▼「半導体技術」に関連する技術解説一覧







