- HOME >
- 専門家による技術解説 >
- EUVレジスト(メタルレジスト)の特徴と技術動向
EUVレジスト(メタルレジスト)の特徴と技術動向
2024.08.20
EUVレジスト(メタルレジスト)の特徴と技術動向
1. はじめに
EUVリソグラフィは、スマートフォン用のデバイス等の最先端デバイス(3nmロジックノード(最小パターン線幅12nm))の製造に用いられている。
EUVリソグラフィは、波長の短い極端紫外線(Extreme Ultra Violet(EUV):13.5nm)を用いるために、使用されるレジストの特性が従来の波長に対応していたレジストとは大きく異なる。また、EUVレジストは、薄膜で光吸収を大きくするような化学増幅型EUVレジストが開発されてきたが、よりレジストの性能を向上させて次世代デバイスに対応するために、EUVメタルレジストが開発され注目されている。本稿ではEUVレジストおよびEUVメタルレジストの最新技術を紹介し、今後の動向についてまとめる。
2. EUVレジスト
2-1. EUVレジストの特徴
EUVの波長領域では、透過率がポリマーの結合様式ではなく、構成原子の吸収とその数で決定される。ただしEUVレジストは薄膜で使用されるために、膜厚の透過率の課題がなくなり、フェノールポリマー、アクリルポリマー等いずれも使用可能となる。
化学増幅型EUVレジストの酸発生機構は、従来のKrFエキシマレーザやArFエキシマレーザ用の化学増幅型レジストと異なる。従来の化学増幅型レジストでは、酸発生剤がKrFエキシマレーザ光やArFエキシマレーザ光を吸収して酸を発生する。一方、化学増幅型EUVレジストでは、レジスト中のポリマーがEUV光を受けとってイオン化し、2次電子を放出する。2次電子がレジスト中の酸発生剤に吸収されて酸を発生することになる(図1)。

図1. 化学増幅型EUVレジストの酸発生機構
2-2. EUVレジストの設計指針
ポリマーのイオン化が酸発生につながり、膜厚の透過率の課題がないことから、EUV光に吸収が大きいフッ素元素や吸収の大きいメタル元素(Zn,In,Sn等)のレジストへの導入が高感度化のために検討されている。
解像度、ラインエッジラフネスについては、発生した酸が過度に動くと性能の劣化につながるため、酸拡散長が短い酸発生剤が求められる。酸発生剤がポリマーにバウンドしたようなポリマーバウンド酸発生剤等が提案されている。
2-3. EUVレジストの課題
EUVレジストでは、感度、解像度、ラフネスのトレードオフという課題がある。(ハーフピッチ)3X(ラインエッジラフネス)2X感度で定義されるZファクターの値が小さいほどバランスのとれたトレードオフの課題が少なく性能のよいEUVレジストとされている。
またEUVレジストでは、ランダム欠陥の発生(Stochastic effects)の課題がある。EUVでは1個あたりのフォトンのエネルギーが高い(193nmに比べて約14倍)ために、レジスト解像に必要なフォトン数が非常に少なく、ばらつきが大きくなる(フォトンショットノイズ)。ばらつきの大きいフォトンから発生する二次電子、化学増幅反応もばらつきが大きくなりラフネスが増大するためである。原理的に露光量を多くすれば欠陥は低減するが感度の低下にもつながるので、光源出力のより向上が求められる。酸発生剤のレジスト膜内での分布を均質化して、パターン形状を向上させ欠陥を低減させるというようなレジストからの対策も考案されている。
2-4. EUVレジストの動向
通常の化学増幅型EUVレジストの現像を有機溶媒現像で行うことでネガレジストパターンに反転させるネガレジストの開発が行われている。露光部の親水性部分が有機溶媒にほとんど溶解しないという特性を利用している。コンタクトホールやスリットというような光が入射しにくいパターンにおいて、ネガレジストでは光コントラストが向上するために有用である。
また、EUVメタルレジストも注目される技術であり次に紹介する。
3. EUVメタルレジスト
3-1. EUVメタルレジストの特徴
Snなどのメタルを含有したレジストは、EUV光をより吸収し非化学増幅型でも高感度になるために注目されている。吸収が大きいために同一の露光量ではフォトンの数が多くなることから、フォトンショットノイズというフォトン1個あたりのエネルギーが高いことによるレジスト解像のばらつき(ランダム欠陥)を低減する効果がある。メタルレジストはエッチング耐性が向上するので、薄膜で用いることができることから、パターンの倒れを防止して解像性の向上にもつながる。
なお全てのメタルにおいて吸収が大きいわけではなく、Zn,In,Sn等が吸収の大きいメタル元素として知られている。Zr,Hf等は吸収が少ない。
3-2. EUVメタルレジストの原理・性能
図2に典型的なメタルレジストのパターン形成メカニズムを示す。感光性リガンドを含むメタルオキソ-ハイドロクラスターを成膜し、EUV露光と露光後加熱を行う。露光部は、感光性リガンドが消失し、メタルオキサイド構造となる。有機溶媒現像により、未露光部のメタルオキソ-ハイドロクラスター部分が溶解し、露光部のメタルオキサイド部分は溶解しないことから、ネガレジストパターンが得られる。非化学増幅型レジストである。
このタイプのレジストは、通常の化学増幅型レジストと同等の解像性を有している。メタルの吸収により2割以上感度が向上、エッチング耐性は10~40倍向上した。エッチング耐性が高いために、通常は下層エッチングのために必要なハードマスクを省いて平坦化層(スピン・オン・カーボン(SOC))のみ使用の簡便なプロセス構造も可能となる。
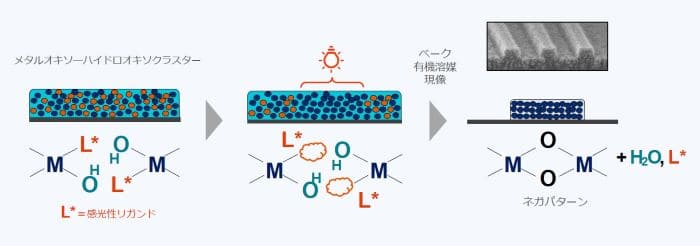
図2. メタルレジストのパターン形成メカニズムの例
3-3. メタル増感剤
メタル増感剤は、レジストの感度を向上させる添加剤である。レジストのポリマーの骨格はそのままにして、吸収の大きいメタル化合物をレジスト中に添加する。レジストの解像性に影響を与えないようにすることが重要である。開発された例では、メタル塩(カチオン部がメタル)の添加で、感度が30~50%向上した。
3-4. メタルレジストの動向
現在の3nmロジックノードでは通常の化学増幅型レジストが引き続き用いられる。2025年の2.1nmロジックノード(最小パターン線幅10nm)では解像性を向上させるために、NA(開口数)が現在の0.33から0.55と大きくなる露光装置を使用する。このため、焦点深度が減少する。また、解像性向上、パターン倒れ防止の観点からも、レジストの膜厚をより薄膜(約20nm以下)にする必要がある。このような必要性を満たすためにこの世代からメタルレジストの需要は急成長していくことが予測される。
最先端のレジストであるメタルレジストは最も微細化が進んでいるロジックデバイスへの適応が見込まれるが、DRAMへの適応についても検討が始まっている。
4. おわりに
本稿では、EUVレジストおよびEUVメタルレジストの最新技術と今後の動向についてまとめた。 EUVレジストでは、感度、解像度、ラフネスのトレードオフ、フォトンショットノイズによるランダム欠陥の発生の課題の早期解決が必要である。
また、EUVメタルレジストは、重金属をレジスト中に積極的に導入するというコンセプトで注目されている。有機溶媒現像と合わせて新規な材料であることから、量産工程への適用の課題(例えばレジストパターン形成後のレジスト除去等)が必ずしもクリアになっていない。性能的に大きな期待があるので、課題の整理と今後の一層の発展が望まれる。
株式会社英知継承では、本テーマに関して当該専門家による技術コンサルティング(技術支援・技術協力)が可能です。下記よりお気軽にお問い合わせください。
▼「半導体技術」に関連する技術解説一覧







